中國粉體網訊 在人工智能浪潮席卷全球的當下,芯片性能成為科技競爭的核心,而玻璃基板以其獨特優勢,成為這場競賽的關鍵。
玻璃基板:打破傳統硅基材料的瓶頸
長期以來,硅基材料憑借出色的導電性和成熟工藝,在芯片制造領域占據統治地位。但隨著高性能計算、人工智能和5G技術的迅猛發展,硅基材料的物理極限逐漸顯現,散熱瓶頸、信號延遲和成本壓力嚴重制約芯片性能提升。在此背景下,玻璃基板憑借卓越的物理化學特性,成為半導體封裝領域的破局關鍵。
玻璃基板具有極佳的尺寸穩定性,能夠承載更大面積、更精細的圖案,其熱膨脹系數與硅相同,平整度極高。低介電常數是玻璃基板的另一大優勢,它能大幅減少信號傳播延遲和串擾,降低互連電容,實現更快信號傳輸,顯著提升數據中心、電信和高性能計算等領域的系統效率與數據吞吐量。
巨頭布局:差異化戰略搶占技術高地
三星:三星在玻璃中介層的布局獨具匠心,沒有隨大流采用510x515毫米的大尺寸玻璃面板,而是專注開發小于100x100毫米的小尺寸面板,通過加快原型驗證進程,力求在市場競爭中率先發力。盡管小尺寸可能降低制造效率,但行業普遍認為,這一策略能助力三星更快將技術推向市場。
三星設備解決方案部門計劃2027年實現“玻璃中介層”量產,用以替代昂貴的傳統有機塑料封裝基板。該項目已與美國材料巨頭康寧展開合作,并聯合眾多中小企業,強化在先進封裝領域的生態整合能力。其戰略分短期與長期推進,短期聚焦先進封裝應用,長期瞄準半導體制造環節。
臺積電:在推進先進封裝技術的進程中,臺積電宣布大力開發扇出型面板級封裝技術,明確選定玻璃基板作為核心材料,計劃在早期階段為英偉達生產首批基于玻璃基板的芯片。
在技術路徑層面,臺積電重點聚焦玻璃芯扇出和TGV工藝的研發。初期采用Chip-First方法,該方法先將芯片固定在臨時載板上,再通過塑封、研磨、布線等工序完成封裝結構的構建。其優勢在于能實現高密度布線,控制封裝厚度,不過對工藝控制要求頗高。之后過渡到Chip-Last工藝,此工藝先在玻璃載體晶圓上構建多層精細的重布線層(RDL),再進行芯片貼裝與模塑,通過紫外線激光照射脫模。它的好處是可提前檢測RDL,避免將芯片放置在有問題的RDL位置上,提高封裝良率。后續還計劃實現TGV工藝量產,在量產前,臺積電將不斷優化玻璃基板深寬比設計,持續提升封裝性能。
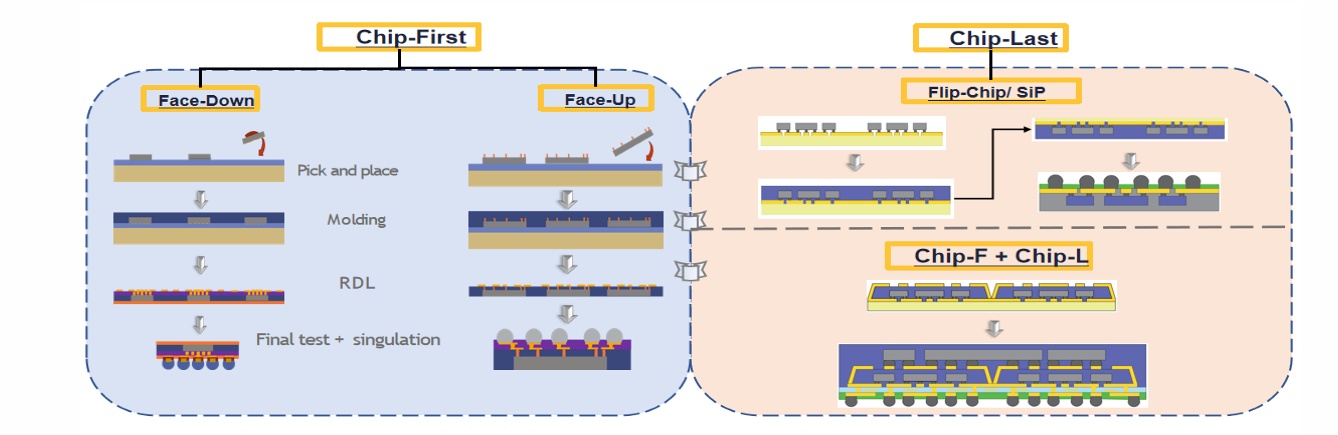
板級封裝工藝路線 來源:中泰證券研究所
英特爾:英特爾早在約十年前就開始布局玻璃基板領域,通過持續高額研發投入,已取得多項關鍵技術突破。2023年9月,英特爾推出業界首個用于下一代先進封裝的玻璃基板技術,以實心玻璃芯替代傳統編織玻璃芯,大幅提升尺寸穩定性、通孔密度和信號傳輸速度,使芯片上裸片放置數量增加50%,顯著提升多芯片系統級封裝的密度和性能。
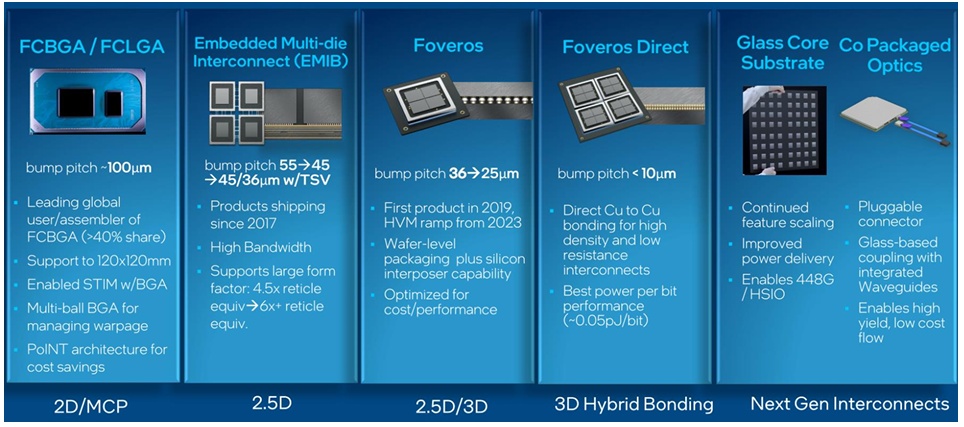
英特爾先進封裝迭代路線圖 來源:廣發證券發展研究中心
為支撐這一技術路線,英特爾在過去十年投入約10億美元,在美國亞利桑那州建立專門研發線和供應鏈,計劃2026-2030年推出完整解決方案。目前,英特爾正將玻璃基板技術與共同封裝光學元件結合,瞄準AI芯片和高性能計算領域,以此鞏固在先進封裝領域的話語權。
商業化挑戰:標準缺失與技術瓶頸并存
盡管玻璃基板市場需求旺盛,但其商業化進程面臨諸多阻礙。首要難題是缺乏統一標準,玻璃基板在尺寸、厚度和特性方面尚未形成全球通用規范,這給設備制造商生產通用兼容設備帶來巨大挑戰。
作為玻璃基板應用于先進封裝的玻璃通孔(TGV)技術仍存在諸多難點。雖然歐美日在該技術開發應用上較為成熟,但在光刻實現小于2µm線距時,玻璃基板需承受更嚴苛加工條件,如何充分發揮光刻工具效能成為最大挑戰。
這場因玻璃基板而起的芯片“封裝競賽”,已成為檢驗三大巨頭技術實力的試金石,更將深刻重塑半導體行業未來版圖。在標準化缺失、工藝復雜等重重挑戰下,或許率先攻克技術難關,實現玻璃基板規模化、商業化量產的企業將搶占行業發展的制高點。
參考來源:
臺積電、英特爾、三星、康寧官網
廣發證券《玻璃基板從零到一,TGV為關鍵工藝》
中泰證券《先進封裝之板級封裝:產業擴張,重視設備機遇》
東興證券《玻璃基板行業五問五答——新技術前瞻專題系列(二)》
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!


















