中國粉體網訊 在半導體產業的發展進程中,封裝技術始終扮演著至關重要的角色。隨著電子產品不斷向小型化、高性能化、多功能化方向發展,對芯片封裝的要求也日益嚴苛。扇出型封裝作為先進封裝技術的代表,正逐漸成為行業焦點,而TGV技術的融入,更為扇出型封裝注入了新的活力。
扇出型封裝:半導體封裝的新趨勢
隨著5G、人工智能(AI)以及物聯網(IoT)等前沿技術的廣泛普及,手機、平板電腦、計算機、汽車等諸多領域蓬勃發展,這不僅對芯片性能提出了更高要求,也推動了封裝技術的持續創新。
傳統的扇入型封裝通常先對整片晶圓芯片進行封裝測試,再切割成單顆芯片,其封裝尺寸往往與芯片尺寸一致。當芯片的輸入/輸出(I/O)數量不斷增加,芯片尺寸難以容納所有I/O時,便難以滿足需求。扇出型封裝則基于創新的重組技術,先將芯片切割,再重新嵌埋到重組載板上,完成嵌埋后進行封裝測試,最后將重組載板切割為單顆芯片。這種設計允許將引腳放置在芯片區域之外,再分布層(RDL)布線方式更為靈活,不僅能向內布線,還能向外布線,從而大幅增加芯片的I/O數量,有效突破了高I/O需求下芯片封裝的瓶頸。
TGV技術:扇出型封裝的強大助推器
目前,TGV技術在半導體封裝領域的重要性日益凸顯。它是指以硼硅玻璃、石英玻璃等為基礎材料,通過一系列工藝,如通孔或盲孔成型、種子層濺射、電鍍填充等,來實現三維(3D)互連的技術,是玻璃基板能夠應用于先進封裝的核心所在,為玻璃基板在扇出型封裝中的應用搭建了橋梁。
與硅通孔(TSV)技術相對應,TGV三維互連技術具備諸多突出優勢。從材料特性來看,玻璃屬于絕緣體材料,其介電常數僅約為硅材料的三分之一,損耗因子更是比硅材料低2-3個數量級。這一特性使得玻璃基板在信號傳輸過程中,襯底損耗和寄生效應顯著降低,有力地保障了傳輸信號的完整性,在高頻領域展現出巨大的應用潛力;從材料獲取方面,Corning、Asahi以及SCHOTT等知名玻璃廠商能夠提供超大尺寸(>2m×2m)和超薄(<50μm)的面板玻璃以及超薄柔性玻璃材料,為大尺寸超薄玻璃襯底的獲取提供了便利條件;從技術本身的優勢而言,TGV技術工藝流程相對簡潔,同時,隨著技術發展和規模化生產,其在成本控制上更具有潛力,能為企業帶來更好的經濟效益。
TGV技術在扇出型封裝中的應用
喬治亞理工學院研究團隊基于TGV技術,在70μm、300mm×300mm規格的玻璃面板上,成功實現26顆芯片的扇出型封裝,并通過創新工藝有效控制芯片偏移與翹曲問題,該技術采用分層鍵合互連方案,首先將預制TGV基板與帶有微結構的玻璃空腔基板進行低溫鍵合,構建三維互連框架,隨后將芯片精準嵌入玻璃空腔內,通過RDL工藝實現芯片與TGV基板的電氣連接。廈門大學提出了工藝流程更簡單的嵌入式玻璃扇出(eGFO)封裝技術,取消了鍵合工序,采用激光誘導刻蝕法制備玻璃空腔和TGV,將芯片嵌入玻璃空腔中,并成功應用于77GHz汽車雷達芯片的封裝中。
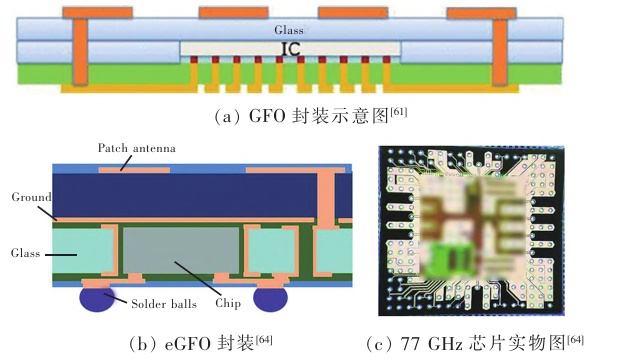
基于玻璃基板的扇出型封裝技術示意圖 來源:Yu.Development of em bedded glass wafer fan-out package with 2D antenna arrays for 77 GHz millimeter-wave chip
展望未來:TGV技術與扇出型封裝的發展前景
毋庸置疑,TGV技術憑借其在高頻性能、互連密度、成本潛力等方面的獨特優勢,將在扇出型封裝中扮演愈發關鍵的角色,二者的深度融合有望為半導體產業帶來更多的創新與突破。
在未來的發展中,TGV技術有望在多個方面取得突破。在工藝方面,隨著新型制造設備和工藝的不斷涌現,TGV的加工精度和質量將得到進一步提升,同時成本將進一步降低;在散熱技術方面,新的散熱設計理念和高性能熱管理材料的研發和應用,將有效克服玻璃基板熱導率低的缺點,滿足高功率芯片日益增長的散熱需求,確保芯片在各種復雜工況下都能穩定運行;在測試技術方面,針對玻璃基板特性專門開發的高精度測試設備和方法將不斷完善和成熟,為TGV技術在扇出型封裝中的可靠應用提供堅實的保障,確保每一個封裝產品都能符合嚴格的性能標準。
參考來源:
劉丹.玻璃通孔成型工藝及應用的研究進展
Yu.Development of em bedded glass wafer fan-out package with 2D antenna arrays for 77 GHz millimeter-wave chip
SHI.First demonstration of panel glass fan-out (GFO) packages for high I/O density and high frequency multi-chip integration
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!


















