中國粉體網訊 近年來隨著電子產業的高速發展,高功率化已經成為現代半導體產業變革的必然趨勢,電子封裝熱管理的重要性也日益凸顯。封裝材料的應用需要考慮兩大基本性能要求,一是高的熱導率,以實現熱量的快速傳遞,保證芯片可以在理想的溫度條件下穩定工作;二是可調控的熱膨脹系數,從而與芯片和各級封裝材料保持匹配,降低熱應力的不良影響。金剛石/金屬復合材料因其優異的熱物理性能,在封裝領域具有重要的應用潛力。
金剛石/銅復合材料具有高導熱性、低密度、低熱膨脹系數等優異特性。然而金剛石與銅的界面親和性差,存在較高的界面熱阻,改善金剛石/銅界面親和性、提高其熱導率通常從燒結方法和金剛石與銅的界面調控兩方面入手。金剛石/銅復合材料制備方法主要包括高溫高壓法、真空熱壓燒結法、熔體浸滲法、放電等離子燒結法等,制備工藝方法各有利弊。界面調控可以通過基體合金化、金剛石表面金屬化和界面形態結構設計來實現。
此前,哈爾濱工業大學朱嘉琦、曹文鑫團隊提出的高溫層壓工藝可實現極高的尺寸精度,與傳統熱壓工藝相比,該工藝操作更簡便且制造成本更低,可解決表面光潔度差、尺寸精度低及性能問題。主要是采用鎢涂層金剛石和銅片作為原料,將鎢涂層金剛石置于銅片上,分層后進行熱壓。該工藝利用銅金屬在高溫下具有高塑性和低流動應力的特性,使銅填充金剛石顆粒間的孔隙并使板材致密化。
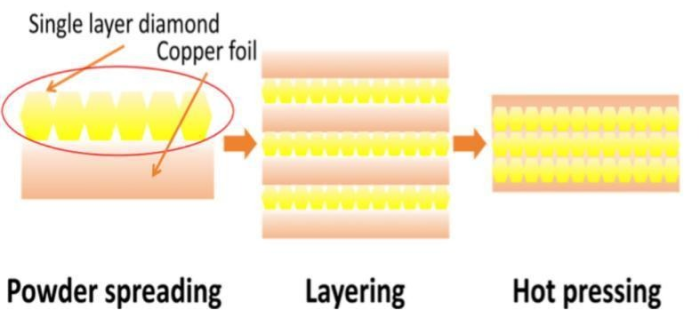
高溫層壓金剛石/銅復合板的流程圖
通過高溫層壓工藝制備的金剛石/銅復合材料的熱導率可達630.3W/m•K。與傳統熱壓工藝相比,高溫層壓工藝制備的復合材料具有更高的平整度和精度。此外,復合板的彎曲強度高達283.7MPa。值得注意的是,經過100次熱沖擊循環后,復合板的熱導率僅下降1%。涂層中的金剛石和鎢碳化物形成高度穩定的半共生相界。
2025年11月5日,中國粉體網將在河南•鄭州舉辦“2025半導體行業用金剛石材料技術大會”。屆時,我們邀請到哈工大鄭州研究院曹文鑫研究員出席本次大會并作題為《電子封裝用高導熱金剛石/金屬復合材料制備技術及組織演變研究》的報告。報告將圍繞高導熱金剛石/金屬復合材料,闡述金剛石鎢鍍層制備、結構機制及創新性高溫層壓工藝,為高熱導率復合材料開發提供理論與技術支撐。
專家簡介
曹文鑫,博士畢業于哈爾濱工業大學,美國密歇根大學聯培,博士后導師韓杰才教授,現哈工大鄭州研究院研究員,哈工大鄭州研究院紅外薄膜與晶體研究所副所長,河南省超硬復合材料及制品工程技術研究中心主任。長期從事先進電子封裝材料研究。主持國家自然科學基金、省重點研發計劃、博士特別資助、國防軍工類項目等縱向/橫向項目30余項,累計發表論文70余篇,受理授權國家/國防專利50余項。對高導熱金剛石復合材料領域技術前沿與發展趨勢有深刻見解。

(中國粉體網編輯整理/石語)
注:圖片非商業用途,存在侵權請告知刪除!




















